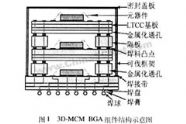
根据IPAS的定义,MCM技术是将多个LSI/VLSI/ASIC裸芯片和其它元器件组装在同一块多层互连基板上,然后进行封装,从而形成高密度和高可靠性的微电子组件。根据所用多层布线基板的类型不同,MCM可分为叠层多芯片组件(MCM –L)、陶瓷多芯片组件(MCM -C)、淀积多芯片组件(MCM -D)以及混合多芯片组件(MCM –C/D)等。
MCM-L 是使用通常的玻璃环氧树脂多层印刷基板的组件。布线密度不怎么高,成本较低。
MCM-C 是用厚膜技术形成多层布线,以陶瓷(氧化铝或玻璃陶瓷)作为基板的组件,与使
用多层陶瓷基板的厚膜混合IC 类似。两者无明显差别。布线密度高于MCM-L。
MCM-D 是用薄膜技术形成多层布线,以陶瓷(氧化铝或氮化铝)或Si、Al 作为基板的组件。
布线密谋在三种组件中是最高的,但成本也高。
多芯片组件是在高密度多层互连基板上,采用微焊接、封装工艺将构成电子电路的各种微型元器件(IC裸芯片及片式元器件)组装起来,形成高密度、高性能、高可靠性的微电子产品(包括组件、部件、子系统、系统)。它是为适应现代电子系统短、小、轻、薄和高速、高性能、高可靠、低成本的发展方向而在PCB和SMT的基础上发展起来的新一代微电子封装与组装技术,是实现系统集成的有力手段。
多芯片组件已有十几年的历史,MCM组装的是超大规模集成电路和专用集成电路的裸片,而不是中小规模的集成电路,技术上MCM追求高速度、高性能、高可靠和多功能,而不像一般混合IC技术以缩小体积重量为主。
典型的MCM应至少具有以下特点[2]:
(1)MCM是将多块未封装的IC芯片高密度安装在同一基板上构成的部件,省去了IC的封装材料和工艺,节约了原材料,减少了制造工艺,缩小了整机/组件封装尺寸和重量。
(2)MCM是高密度组装产品,芯片面积占基板面积至少20%以上,互连线长度极大缩短,封装延迟时间缩小,易于实现组件高速化。
(3)MCM的多层布线基板导体层数应不少于4层,能把模拟电路、数字电路、功率器件、光电器件、微波器件及各类片式化元器件合理而有效地组装在封装体内,形成单一半导体集成电路不可能完成的多功能部件、子系统或系统。使线路之间的串扰噪声减少,阻抗易控,电路性能提高。