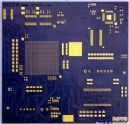
最早的表面安装技术--倒装芯片封装技术(FC)形成于20世纪60年代,同时也是最早的球栅阵列封装技术(BGA)和最早的芯片规模封装技术(CSP)。
倒装芯片封装技术为1960年IBM公司所开发,为了降低成本,提高速度,提高组件可靠性,FC使用在第1层芯片与载板接合封装,封装方式为芯片正面朝下向基板,无需引线键合,形成最短电路,降低电阻;采用金属球连接,缩小了封装尺寸,改善电性表现,解决了BGA为增加引脚数而需扩大体积的困扰。再者,FC通常应用在时脉较高的CPU或高频RF上,以获得更好的效能,与传统速度较慢的引线键合技术相比,FC更适合应用在高脚数、小型化、多功能、高速度趋势IC的产品中。
1.形成凸点技术
凸点形成技术分为几个简单的类型,即淀积金属、机械焊接、基于聚合物的胶粘剂以及别的组合物。最初的C4高铅含量焊料凸点,熔点在300℃以上,被低共熔焊料和胶粘剂代替,从而使压焊温度下降到易于有机PCB承受的范围。然而,如果低共熔焊膏作为接合材料使用,那么C4仍可用于FR-4上。
1.1 机械形成凸点技术
十多年前,IBM公司和K&S公司开发了球凸点形成工艺技术,称为柱式凸点形成技术。此工艺过程首先涉及到对铝芯片载体的球压焊技术,接着把焊丝拉到断裂点,最后形成有短尾部的凸点。为了在球附近形成光滑的断裂口,可使用含有1%铂的金丝。焊料和别的金属也是起作用的。很多改变是明显的,包括平面性方面的凸点精压技术和更高、更复杂的金属化的双凸点形成技术。柱式凸点形成技术,长期使用于试制形式。由于通过引线键合机获得了惊人的速度,已移入生产模式。金和金凸点及焊料凸点均被实施。Delco公司和K&S公司联合生产柱式凸点的倒装芯片产品,别的公司在不远的将来预计生产凸点芯片。
1.2 金属电镀技术
电镀技术要求首先形成总线接头,选择电镀掩模,并用于TAB的金凸点芯片技术。虽然通过在晶圆片上方汽相淀积金属,在典型状况下形成总线,但是总线必须能被清除。再者,必须提供光成像电镀保护膜,在电镀之前成像并显影。很多步骤和精确的电镀掩模工艺的要求增加了成本和不便因素。
化学镀是无掩模和无总线的方法,看上去是一种较好的方法。该技术已广泛地应用于印刷电路行业,但是化学形成凸点的技术仅仅是近年来才应用于倒装芯片的。化学镀镍,也许由于其非常精确的化学性质,已呈现为首要的且普遍的化学倒装片凸点技术工艺。如果铝没有直接与镍一起电镀,就可使用中间浸液电镀锌技术。图2示出了最普遍的镍凸点技术顺序。注意到在典型状况下,镍受到薄的、易于产生浸液的金涂层保护。形成的金毛刺适于焊接及胶粘剂压焊。