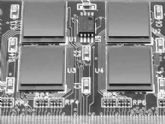
在BGA技术开始推广的同时,另外一种从BGA发展来的CSP封装技术正在逐渐展现它生力军本色。作为新一代的芯片封装技术,在BGA、TSOP的基础上,CSP的性能又有了革命性的提升。
CSP封装可以让芯片面积与封装面积之比超过1:1.14,已经相当接近1:1的理想情况,绝对尺寸也仅有32平方毫米,约为普通的BGA的1/3,仅仅相当于TSOP内存芯片面积的1/6。与BGA封装相比,同等空间下CSP封装可以将存储容量提高三倍。
随着便携式手持设备市场持续增长,CSP开始成为主流封装形式之一,但到目前为止,大多数CSP封装方案都只是针对某个专门产品、或针对一个小范围的产品。
1.CSP封装内存不但体积小,同时也更薄,其金属基板到散热体的最有效散热路径仅有0.2毫米,大大提高了内存芯片在长时间运行后的可靠性,线路阻抗显著减小,芯片速度也随之得到大幅度提高。
2.CSP封装的电气性能和可靠性也相比BGA、TOSP有相当大的提高。在相同的芯片面积下CSP所能达到的引脚数明显的要比TSOP、BGA引脚数多的多(TSOP最多304根,BGA以600根为限,CSP原则上可以制造1000根),这样它可支持I/O端口的数目就增加了很多。此外,CSP封装内存芯片的中心引脚形式有效的缩短了信号的传导距离,其衰减随之减少,芯片的抗干扰、抗噪性能也能得到大幅提升,这也使得CSP的存取时间比BGA改善15%-20%。
3.在CSP的封装方式中,内存颗粒是通过一个个锡球焊接在PCB板上,由于焊点和PCB板的接触面积较大,所以内存芯片在运行中所产生的热量可以很容易地传导到PCB板上并散发出去。CSP封装可以从背面散热,且热效率良好,CSP的热阻为35℃/W,而TSOP热阻40℃/W。
CSP产品的品种很多,封装类型也很多,因而具体的封装工艺也很多。不同类型的CSP产品有不同的封装工艺,一些典型的CSP产品的封装工艺流程如下:
1.柔性基片CSP产品的封装工艺流程
柔性基片CSP产品,它的芯片焊盘与基片焊盘问的连接方式可以是倒装片键合、TAB键合、引线键合。采用的连接方式不同,封装工艺也不同。
(1)采用倒装片键合的柔性基片CSP的封装工艺流程
圆片→二次布线(焊盘再分布) →(减薄)形成凸点→划片→倒装片键合→模塑包封→(在基片上安装焊球) →测试、筛选→激光打标。
(2)采用TAB键合的柔性基片CSP产品的封装工艺流程