BGA封装,BGA封装的分类,BGA封装参数指标等
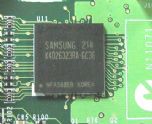
20世纪90年代随着技术的进步,芯片集成度不断提高,I/O引脚数急剧增加,功耗也随之增大,对集成电路封装的要求也更加严格。为了满足发展的需要,BGA封装开始被应用于生产。该技术的出现成为CPU、主板南、北桥芯片等高密度、高性能、多引脚封装的最佳选择。
BGA的封装类型多种多样,其外形结构为方形或矩形。根据其焊料球的排布方式可分为周边型BGA、交错型BGA和全阵列型BGA;根据其基板的不同,主要分为三类:PBGA(PlasticballZddarray塑料焊球阵列)、CBGA(ceramicballSddarray陶瓷焊球阵列)、TBGA (tape ball grid array载带型焊球阵列)。
1.I/O引脚数虽然增加了,但引脚间距并没有减小反而增加了,提高了组装成品率。
2.虽然功耗增加,但BGA能用可控塌陷芯片法焊接,由此改善它的电热性能。
3.该技术的组装可用共面焊接,从而能大大提高封装的可靠性。
4.该技术实现的封装寄生参数减小,CPU信号传输延迟小,使用频率大大提高。
5.厚度和重量都较以前的封装技术有所减少。
6.BGA封装占用基板的面积比较大。
采用BGA技术封装的内存,可以使内存在体积不变的情况下,内存容量提高两到三倍,BGA与TSOP相比,具有更小体积,更好的散热性能和电性能。BGA封装技术使每平方英寸的存储量有了很大提升,采用BGA封装技术的内存产品在相同容量下,体积只有TSOP封装的三分之一;与传统TSOP封装方式相比,BGA封装方式有更加快速有效的散热途径。
TSOP封装